제품소개
-
신뢰성 장비란
- 시스템반도체의 수명시험 평가 가능한 제품이며, 고온, 바이어스, 전압 등 실동작 조건에서 동시 인가가능한 제품
IOL
Intermittent Operation LifeIntermittent Operation Life (IOL) 시험은 전원 인가·차단을 반복해 접합온도 변화(ΔTJ)를 유도하고,
반복적인 열 스트레스로 소자의 장기 신뢰성과 내구성을 평가하는 시험입니다.
-
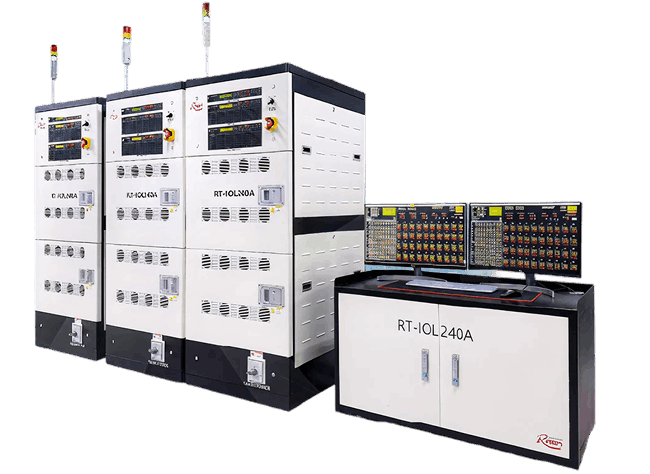
- 장비 spec
-
External Size: (W)2,600mm X (D)1,000mm X (H)1,985mm
Density: 240 test density per 3 test system
Test Zone: 6 test zone per 3 test system
Test Slot: 20 test density per 1 test slot
Support Products: Power Device - TO / SMT
Power Supply: (Gate) 30V / 20A, (Voltage) 100V / 150A
Temperature Range: 25℃~200℃
Temperature Accuracy: 3℃ or less
Falling / Rising Time: 60 sec. / 60 sec. *junction temp.
Monitoring Parameter: TC, I-Load, U-Load, Ureverse, Rthjc, Tj, VDS(RDSON), Current, Temperature, Gate Bias
- 시험 spec
- TA=25°C에서 진행. 부품에 전원을 공급하여 ΔTJ 100°C를 보장하고 (절대 최대 정격을 초과하지 않도록 함).
HSB System
High Speed Burn-in test System고속 HTOL 시험 장비로, 기존 가속수명시험 장비의 한계(최대 10 MHz)를 넘어
실제 동작 환경에 근접한 최대 3 GHz급 고속 동작 수명시험 입니다.
-
반도체 동작주파수의 증가에 따른 기존 HTOL test(10Mhz) 에서 동작 불가능한 부분의 고속 주파수 동작 시험 필요함
-
Digital System에서 신호가 제대로 전달 되지 않는다면 오작동이 발생하거나 정상적인 동작을 실행할 수 없음
-
고속(실동작) 시험/평가 진행으로 반도체 초기 설계 검증, 반도체 출하 품질 경쟁력 강화, 추후 발생되는 품질 비용 감소
-
HTOL 시험의 동작 속도를 User operation Test 환경에서 진행을 목적으로 high speed 시험을 진행 합니다.
-
가속수명시험 장비의 한계점(Max. 10Mhz)을 자체 개발된 High speed board System의 기술을 적용 실제 구동 환경과 가까운 3GHz급 HTOL 시험을 목적으로 하고 있습니다.
-
고속(실동작) 시험/평가 진행함으로 반도체 초기 설계 검증, 반도체 출하 품질 경쟁력 강화, 추후 발생되는 품질 비용 감소 할 수 있습니다.
-
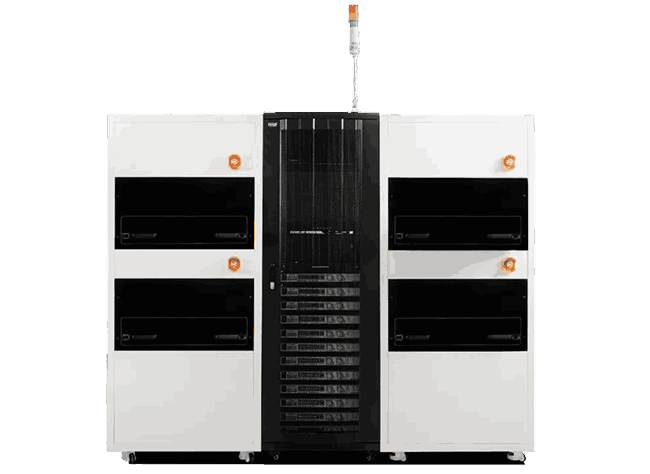
- 장비 spec
-
External Size: (W)1,600mm X (D)1,400mm X (H)2,373mm
Temperature: 1 temperature control / sensing
25℃ ~ 150℃ temp. range < range>Power System: 0V ~ 30V/20A power range * 7unit
0V ~ 30V/20A power range * 1unit
200ms power response timeVector Data Speed Rate: 2Gbps~
Signal Information(Input Level): (VIH) 0.8V, (VIL) 0.2V
Maximum Number of Input: Max 24 differential signal per 1 target package
Function for Monitoring of Test Status: Voltage, Current, Temperature
High Temperature Operating Life test duration / temperature
| JEDEC (Industrial) | AEC-Q100 (Automotive) |
|---|---|
| 1000hrs , 125°C ≤ Tj , Vcc Max | Grade 0 : +150 °C for 1000 hours |
| Grade 1 : +125 °C for 1000 hours | |
| Grade 2 : +105 °C for 1000 hours | |
| Grade 3 : +85 °C for 1000 hours |
HTOL
High Temperature Operating Life동작시의 열적, 전기적인 문제점을 평가 하는 목적, 일반적으로 공정 또는 설계상의 문제점을 찾을 수 있으며
제품의 수명을 추정하는데에 사용 가속인자 (온도 및 전압)을 이용 하여 시장에서의 제품
-
불량율(FIT : Failure-in Time) 및 평균 수명 (MTTF : Mean Time To Failure) 을 예측 하기 위해 실시 하며 가능한 Set 실장조건과 유사 하도록 제품을 Operating 시켜야 한다.
-
동작시의 열적, 전기적인 문제점을 평가 하는 목적이며, 일반적으로 공정 또는 설계상의 문제점을 찾을 수 있으며 제품의 수명을 추정하는 데에 사용 되는 항목입니다.
-
가속인자 (온도 및 전압)을 이용 하여 시장에서의 제품 불량율 (FIT : Failure-in Time) 및 평균 수명 (MTTF : Mean Time To Failure)을 예측 하기 위해 실시 하며 가능한 Set 실장조건과 유사 하도록 제품을 Operating 시켜야 합니다.
요약 : HTOL(High Temperature Operating Life) 시험은 고온·고전압 조건에서 소자를 실제 동작시켜 열적·전기적 신뢰성을 평가하는 가속수명시험 입니다. 공정 및 설계상의 잠재 결함을 조기에 검출하고, 가속인자(온도·전압)를 통해 제품의 불량률(FIT)과 평균수명(MTTF)을 예측하며, 실제 세트 실장 환경과 유사한 조건에서 수행됩니다.
-

- 장비 spec
-
가동 온도 범위: 200℃, 전압 : Max : 20V
High Temperature Operating Life test duration / temperature
| JEDEC (Industrial) | AEC-Q100 (Automotive) |
|---|---|
| 1000hrs , 125°C ≤ Tj , Vcc Max | Grade 0 : +150 °C for 1000 hours |
| Grade 1 : +125 °C for 1000 hours | |
| Grade 2 : +105 °C for 1000 hours | |
| Grade 3 : +85 °C for 1000 hours |
ELFR
Early Life Failure Rate가속 스트레스 조건으로 동작시의 열적, 전기적 가속조건을 부여하여 초기 불량을 유발
동작시의 열적, 전기적인 문제점을 평가 하는 목적, 일반적으로 공정 또는 설계상의 문제점을 찾을 수 있으며
제품의 수명을 추정하는 데에 사용 가속인자 (온도 및 전압)을 이용 하여 시장에서의 제품
-
불량율(FIT : Failure-in Time) 및 평균 수명 (MTTF : Mean Time To Failure) 을 예측 하기 위해 실시 하며 가능한 Set 실장조건과 유사 하도록 제품을 Operating 시켜야 한다.
-
가속 스트레스 조건으로 동작시의 열적, 전기적 가속조건을 부여하여 초기 불량을 유발하여, ELFR구간에서 초기에 발생 할 수 있는 높은 불량을 유발하여 잠재적인 불량을 제거합니다. 현재의 상태에서 앞으로 일어날 불량을 stress를 인가하여 미리 검출하여 Screen
요약 : 가속 스트레스 조건에서 소자를 동작시켜 열적·전기적 결함을 조기에 유발하고, 공정 및 설계상의 잠재 불량을 선별(Screen)하는 시험입니다.
-

- 장비 spec
-
가동 온도 범위: 200℃, 전압 : Max : 20V
Early Failure Rate Duration / Temperature
| JEDEC (Industrial) | AEC-Q100 (Automotive) |
|---|---|
| 48 Hrs ≤ t ≤ 168hrs, 125°C ≤ Tj, Vcc Max | Grade 0: 48 hours at 150°C or 24 hours at 175°C, Vcc Max |
| Grade 1: 48 hours at 125°C or 24 hours at 150°C, Vcc Max | |
| Grade 2: 48 hours at 105°C or 24 hours at 125°C, Vcc Max | |
| Grade 3: 48 hours at 85°C or 24 hours at 105°C, Vcc Max | |
| Grade 4: 48 hours at 70°C or 24 hours at 90°C, Vcc Max |
Precondition
package 제조 완료 시점부터 기판에 부착될 때까지 package 주변 환경을 모의 실험하기 위하여 진행 합니다.
Plastic Package 제품에 적용되는 시험 으로서, 제조자의 제조과정에서 진행되는 제품의 취급 및 저장,
고객에게 전달되는 과정과(Shippability) 관련된 환경시험 및 고객의 IC 를 실장 하는 환경을(Soldering Stress 등) Modeling 한 것으로서,
THB, THS, T/C, PCT, HAST 시험 전에 적용합니다.
요약 : Precondition 시험은 패키지 제조 완료 후 기판 실장 전까지의 보관·취급·운송(Shippability) 환경과 실장 시 발생하는 솔더링 스트레스를 모사하기 위한 시험입니다.
Plastic Package 제품에 적용되며, THB, THS, T/C, PCT, HAST 등 신뢰성 시험 전 단계에서 수행됩니다.
-

- 장비 spec
-
bake 장비 가동 온도 범위: 200℃
항온 항습기 온도 범위: -40~150℃ , 습도 범위 : 30%~98%
Reflow: 9zone 개별 온도 control
상세스펙
| LEVEL | FLOOR LIFE4 | SOAK REQUIREMENTS3 | |||||
|---|---|---|---|---|---|---|---|
| STANDARD | ACCELERATED EQUIVALENT1 | ||||||
| eV 0.40-0.48 |
eV 0.30-0.39 |
CONDITION | |||||
| TIME | CONDITION | TIME(hours) | CONDITION | TIME(hours) | TIME(hours) | ||
| 1 | Unlimited | ≤30 °C/85% RH | 168 +5/-0 | 85 °C/85% RH | NA | NA | NA |
| 2 | 2 year | ≤30 °C/60% RH | 168 +5/-0 | 85 °C/60% RH | NA | NA | NA |
| 2a | 4 weeks | ≤30 °C/60% RH | 6962 +5/-0 | 30 °C/60% RH | 120 +1/-0 | 168 +1/-0 | 60 °C/60% RH |
| 3 | 168 hours | ≤30 °C/60% RH | 1922 +5/-0 | 30 °C/60% RH | 40 +1/-0 | 52 +1/-0 | 60 °C/60% RH |
| 4 | 72 hours | ≤30 °C/60% RH | 962 +5/-0 | 30 °C/60% RH | 20 +0.5/-0 | 24 +0.5/-0 | 60 °C/60% RH |
| 5 | 48 hours | ≤30 °C/60% RH | 722 +5/-0 | 30 °C/60% RH | 15 +0.5/-0 | 20 +0.5/-0 | 60 °C/60% RH |
| 5a | 24 hours | ≤30 °C/60% RH | 482 +5/-0 | 30 °C/60% RH | 10 +0.5/-0 | 13 +0.5/-0 | 60 °C/60% RH |
| 6 | Time on Label(TOL) |
≤30 °C/60% RH | TOL | 30 °C/60% RH | NA | NA | NA |
THB
Temperature Humidity Storage biaslastic Package 제품에 적용되는 시험 으로써, 고온 고습을 유지하여 습기 침투를 가속함으로써
반도체 소자의 Package 공정에 대한 신뢰도를 평가하기 위한 시험이다.
Lead와 Lead간의 Micro Gap 또는 Molding Compound의 기공을 통하여 습기가 침투함으로써
습기 및 이물질에 의해 Pad Metal이 부식되거나 Passivation Crack을 유발하고, Chip표면의 금속 배선 막 부식 및 기타 불량을 유발합니다.
-

- 장비 spec
-
항온 항습기 온도 범위: -40~150℃ , 습도 범위 : 30%~98%
상세스펙
| Spec | Test condition | |||
|---|---|---|---|---|
| Temperature(°C) | Humidity (%) | Bias (V) | Duration (Hrs) | |
| JESD22-A101 | 85°C / ±2 | 85% / ±2 | VCC Max | 1000 |
| 조건 | Reference | 시험 요구/주의사항 |
|---|---|---|
| AEC-Q100 | JEDEC JESD22-A101 or A110 | >85°C/85%RH for 1000 hours or HAST (130°C/85%RH for 96 hours, or 110°C/85%RH for 264 hours). |
HTST
High Temperature StorageHTST (High Temperature Storage Test)는 제품을 장시간 고온에 보관하는 동안, 어떤 영향을 받는지 평가하는 시험입니다.
Electrical stress를 적용하지 않으며 제품의 long-term reliability (장시간에 대한 신뢰성)를 평가하는 것이 목적입니다.
HTST는 시료를 규정된 온도에서 규정된 시간 동안 노출하는 과정으로 이루어 집니다.
고온 저장 시험은 매우 높은 온도를 사용하고 가속할 수 있으나, 매우 높은 온도에서 발생하는 Kirkendal Voiding과 같은 불량 현상은
도입되지 않도록 하거나, 혹은 섭씨 180도 이상의 온도에서의 stress migration과 같은 불량 현상을 억제하는 주의가 필요합니다.
요약 : HTST(High Temperature Storage Test)는 전기적 스트레스 없이 제품을 장시간 고온에 노출하여 장기 신뢰성(Long-term Reliability)을 평가하는 시험입니다.
-

- 장비 spec
-
bake 장비 가동 온도 범위: 200℃
상세스펙
| Spec | Test condition | |||||
|---|---|---|---|---|---|---|
| A | B | C | D | E | F | |
| JESD22-A103 | 125(-0/+10)°C | 150(-0/+10)°C | 175(-0/+10)°C | 200(-0/+10)°C | 250(-0/+10)°C | 300(-0/+10)°C |
| MIL-STD-883E Method 1008 | 75(-0/+10)°C | 125(-0/+10)°C | 150(-0/+10)°C | 200(-0/+10)°C | 250(-0/+10)°C | 300(-0/+10)°C |
| Test Time | 1000(-0, /+72) hrs | |||||
| 조건 | Reference | 시험 요구/주의사항 |
|---|---|---|
| AEC-Q100 | JEDEC JESD22-A103 | >Plastic Packaged Parts |
| >Grade 0 : +175°C Ta for 1000 hours or +150°C Ta for 2000 hours. | ||
| >Grade 1 : +150°C Ta for 1000 hours or +175°C Ta for 500 hours. | ||
| >Grades 2 and 3 : +125°C Ta for 1000 hours or +150°C Ta for 500 hours. | ||
| >Ceramic Packaged Parts : +250°C Ta for 10 hours or +200°C Ta for 72 hours. |
HAST
Highly Accelerated Temperature & Humidity Stress Test적절한 Bias, 가속화된 온도와 고습의 시험 조건을 이용하여 Plastic Package 공정에 대한 신뢰도를 평가하며,
Molding Compound의 기공을 통하여 습기가 침투함으로써 습기 및 이물질에 의해 Pad Metal이 부식되거나
Passivation Crack을 유발하고, Chip표면의 금속 배선 막을 부식시켜 기타 불량을 유발합니다.
제품의 접합부를 통한 Moisture의 침투를 가속시키기 위해 온도/습도/Bias등을 강화 시킨 평가 입니다.
수분 침투를 가속화하는 가혹한 온도, 습도 및 바이어스 조건을 사용 합니다.
스트레스는 85℃/85% 테스트(JEDEC 표준 번호 22-A101)와 동일한 실패 메커니즘을 활성화 합니다.
-
- 장비 spec
-
가동 온도 범위: +105.0 ~ +140℃
가동 습도 범위: 75%~100%
상세스펙
| Spec | Test condition | ||||
|---|---|---|---|---|---|
| Temperature (°C) | Humidity (%) | Vapor Pressure (psia/kpa) |
Bias (V) | Duration (Hrs) | |
| JESD22-A110 | 130°C / ±2 | 85% / ±2 | 33.3 / 230 | VCC Max | 96 (-0/+2) |
| 110°C / ±2 | 85% / ±5 | 17.7 / 122 | VCC Max | 264 (-0/+2) | |
| 조건 | Reference | 시험 요구/주의사항 |
|---|---|---|
| AEC-Q100 | JEDEC JESD22-A101 or A110 | 85°C/85%RH for 1000 hours or HAST (130°C/85%RH for 96 hours, or 110°C/85%RH for 264 hours). |
U-HAST
Unbias-HAST습한 환경에서 비 밀폐 패키지의 신뢰성을 평가하기 위해 수행 합니다.
비 응축 조건에서 온도와 습도를 사용하여 수분 침투를 가속화하는 고도로 가속된 테스트로 바이어스에 의한 고장 유형을 방지하여,
온도와 습도에 의한 고장 메커니즘이 노출될 수 있도록(예: 갈바닉 부식) 보장하기 위해 이 테스트에서는 바이어스를 적용하지 않습니다.
요약: U-HAST(unbias-HAST)는 바이어스를 인가하지 않고 고온·고습 조건에서 수분 침투를 가속하여, 비밀폐 패키지의 습기 내성을 평가하는 시험입니다.
-
- 장비 spec
-
가동 온도 범위: +105.0 ~ +140℃
가동 습도 범위: 75%~100%
상세스펙
| Spec | Test condition | |||
|---|---|---|---|---|
| Temperature (°C) | Humidity (%) | Vapor Pressure (psia/kpa) |
Duration (Hrs) | |
| JESD22-A118 | 130°C / ±2 | 85% / ±2 | 33.3 / 230 | 96 (-0/+2) |
| 110°C / ±2 | 85% / ±5 | 17.7 / 122 | 264 (-0/+2) | |
| 조건 | Reference | 시험 요구/주의사항 |
|---|---|---|
| AEC-Q100 | JEDEC JESD22-A102, A118, or A101 | 121°C/15psig for 96 hours |
| or unbiased HAST (130°C/85%RH for 96 hours, or 110°C/85%RH for 264 hours). | ||
| 고온 고압에 민감한(e.g., BGA) 패키지의 경우, TH (85°C/85%RH)로 1000 hours 대체 가능 |
Autoclave
수분 응축 또는 수분 포화 증기 환경을 사용하여 밀봉된 고체 상태 장치의 내 습성 무결성을 평가 합니다.
응축 조건에서 압력, 습도 및 온도 조건을 사용하여 외부를 통한 수분 침투를 가속화하는 매우 가속화 된 테스트로
보호 물질 (봉지 재 또는 밀봉재) 또는 외부 보호 물질과 이를 통과하는 금속 도체 사이의 계면을 따라 진행 됩니다.
-
- 장비 spec
-
가동 온도 범위: +105.0 ~ +140℃
가동 습도 범위: 75%~100%
상세스펙
| Spec | Step | Test condition | |||||
|---|---|---|---|---|---|---|---|
| A | B | C | D | E | F | ||
| JESD22-A102 | Temperature (Dry Bulb °C) | 121°C ±2 | |||||
| Relative Humidity (%) | 100% | ||||||
| Vapor Pressure (psig) | 2 ATM (30 ±1) | ||||||
| Test Time | 24 hrs (-0/+2) | 48 hrs (-0/+2) | 96 hrs (-0/+2) | 168 hrs (-0/+2) | 240 hrs (-0/+2) | 336 hrs (-0/+2) | |
TC
Temperature Cycle서로 다른 재료로 구성되어 있는 반도체 device & package 등은 각각 열 팽창 개수가 다르기 때문에 열적인 변화에 따른 불량이 가속 됩니다.
이와 같은 급작스런 온도의 환경 변화에 대한 적응력을 평가하기 위한 시험입니다.
반도체 Device는 서로 다른 재료로 구성되어 있으며, 이들은 각각 열 팽창 개수가 다르기 때문에 열적인 변화에 따른 불량이 가속됩니다.
-
- 장비 spec
-
-65~200℃
상세스펙
| Spec | Step | Test condition | ||||||||
|---|---|---|---|---|---|---|---|---|---|---|
| A | B | C | D | E | F | G | H | K | ||
| MIL-STD-883 | Cold | -55°C (-10/+0) | -55°C (-10/+0) | -65°C (-10/+0) | -65°C (-10/+0) | -65°C (-10/+0) | -65°C (-10/+0) | |||
| Hot | 85°C (+10/-0) | 125°C (+10/-0) | 150°C (+10/-0) | 200°C (+10/-0) | 300°C (+10/-0) | 175°C (+10/-0) | ||||
| JESD22-A104 | Cold | -55°C (-10/+0) | -55°C (-10/+0) | -65°C (-10/+0) | -40°C (-10/+0) | -55°C (-10/+0) | -0°C (-10/+0) | |||
| Hot | 85°C (+10/-0) | 125°C (+10/-0) | 150°C (+10/-0) | 125°C (+10/-0) | 150°C (+10/-0) | 125°C (+10/-0) | ||||
| 조건 | Reference | 시험 요구/주의사항 |
|---|---|---|
| AEC-Q100 | JEDEC JESD22-A104 and Appendix 3 | TC 후 WBP 진행 (TC 완료 후 한 lot에서 5개의 샘플을 사용하여 WBP 수행: 모서리당 2개, 측면당 1개 중간 본드) |
| Grade 0: -55°C to +150°C for 2000 cycles or equivalent | ||
| Grade 1: -55°C to +150°C for 1000 cycles or equivalent. (Note: -65°C to +150°C for 500 cycles is also an allowed test condition due to legacy use with no known lifetime issues.) |
||
| Grade 2: -55°C to +125°C for 1000 cycles or equivalent | ||
| Grade 3: -55°C to +125°C for 500 cycles or equivalent |
HBM
Human Body Model / Latch-up전하를 잃거나 얻은 상태의 두 물체가 “반도체”와 “인체”라고 가정한 시험입니다.
인체특성을 모사한 회로를 구성하고 반도체에 ESD pulse를 인가합니다. HBM분류 수준은 250 V ~ 8000 V 입니다.
ESD는 반도체 제품의 주요불량 원인 중 하나로, 전위가 다른 두 물체가 접촉하면서 순간적으로 전하가 이동하는 현상입니다.
인체는 여러 가지 방식으로 전하를 얻거나 잃게 되는데, 흔히 알고 있는 마찰전기를 통해서 Positive 또는 Negative 상태가 됩니다.
반도체장치가 실제 ESD 현상을 겪게 되는 여러 상황이 modeling 되었고 , 각 시험 수준에 따라 제품의 ESD 내성(sensitivity)을 몇가지 등급으로 분류합니다.
Latch-up 시험이란 CMOS 회로 구성에 따른 기생 바이폴라 트랜지스터에 의해 PNPN 구조가 만들어지고 이것이 SCR 동작이 발생하면서
VDD 및 GND에 직접적인 연결통로가 만들어져, 지속적인 과전류의 통로가 되면서 소자가 파괴되는 현상 에 대한 모델링 시험입니다.
요약 : HBM(Human Body Model) 시험은 인체를 모사한 회로로 반도체에 ESD 펄스를 인가하여 정전기 방전에 대한 내성을 평가하는 시험입니다.
250 V~8000 V 범위에서 시험을 수행하며, 실제 사용 환경의 ESD 상황을 모델링해 제품의 ESD 민감도를 등급화합니다.
Latch-up 시험은 CMOS 회로 내 기생 PNPN 구조로 인해 SCR 동작이 발생하여 전원(VDD)과 접지(GND) 사이에 과전류 경로가 형성되는 현상을 평가하는 시험입니다.
-
- 장비 spec
-
Pin Counts: 512ea, HBM 30 V to 2 kV
상세스펙
| Stress | Ref. | Abbr. | Conditions |
|---|---|---|---|
| Human Body Model ESD | JS-001 | ESD-HBM | TA = 25°C |
| Charged Device Model ESD | JESD22-C101 | ESD-CDM | TA = 25°C |
| Machine Model | JESD22-A115 | ESD-MM | TA = 25°C |
| 시험 명 | Reference | 시험 요구/주의사항 |
|---|---|---|
| ESD - Human Body Model | AEC Q100-002 | HBM 자격 테스트는 다음 수준에서 수행 / 건너뛰는 전압 수준은 허용되지 않음 500V, 1000V 및 2000V. 500V에서 장해가 관찰되면 250V에서 HBM 테스트 수행. 250V에서 장해가 관찰되면 125V에서 HBM 테스트 수행. 장치가 250V에서 고장나고 125V에서 파형 요구 사항을 충족하는 테스트를 사용할 수 없는 경우 해당 부품은 클래스 0A (즉, < 125V>AEC Q100-002 Table 3: Integrated Circuit HBM ESD Classification Levels 참고 |
| Items | Consumer / Industrial | Automotive |
|---|---|---|
| Latch-up | JESD78E | AEC-Q100-004 |
CDM
Charged Device ModelField 불량과 가장 밀접한 메커니즘으로 여겨지는 시험입니다. Package에 전하를 충전시킨 후 방전시키는 방법을 사용하며, CDM분류 수준은 200V ~ 1000V 입니다.
ESD는 반도체 제품의 주요불량 원인 중 하나로, 전위가 다른 두 물체가 접촉하면서 순간적으로 전하가 이동하는 현상입니다.
인체는 여러 가지 방식으로 전하를 얻거나 잃게 되는데, 흔히 알고 있는 마찰전기를 통해서 Positive 또는 Negative 상태가 됩니다.
반도체장치가 실제 ESD 현상을 겪게 되는 여러 상황이 modeling 되었고 , 각 시험 수준에 따라 제품의 ESD 내성(sensitivity)을 몇가지 등급으로 분류합니다.
요약 : CDM(Charged Device Model) 시험은 패키지 자체에 전하를 충전한 후 방전시켜, 실제 현장(Field) 불량과 가장 유사한 ESD 메커니즘에 대한 내성을 평가하는 시험입니다.
-
- 장비 spec
-
충전 Test Voltage Range: ±25 ~ ±2000V(±1V 단위)
모션시스템:
X, Y축 - 최소 스텝 크기 0.001, 0.00025 in.의 정확도(X, Y축 - 최소 스텝 크기 25.4µm, 6µm의 정확도)
Z축 - 1.5까지 수직 이동, 0.00025 in.의 정확도(Z축 - 38.1mm까지 수직 이동, 6µm의 정확도)
상세스펙
| Stress | Ref. | Abbr. | Conditions |
|---|---|---|---|
| Charged Device Model ESD | JESD22-C101 | ESD-CDM | TA = 25°C |
| 시험 명 | Reference | 시험 요구/주의사항 |
|---|---|---|
| ESD - Charged Device Model | AEC Q100-011 | AEC Q100-011 Table 1: Integrated Circuit CDM ESD Classification Levels 참고 |
HTRB
High Temperature Reverse BiasHTRB(High Temperature Reverse Bias) 신뢰성 시험은 고온 상태에서 반도체 소자에 역바이어스를 인가하여
PN 접합 및 절연막의 내열·내전압 특성을 평가하는 시험입니다.
본 시험은 장기 신뢰성, 누설 전류 안정성, 수명 특성을 검증하기 위한 핵심 항목
요약 : HTRB(High Temperature Reverse Bias) 시험은 고온 환경에서 소자에 역바이어스를 인가하여
PN 접합과 절연막의 내열·내전압 특성 및 누설 전류 안정성을 평가하는 장기 신뢰성 시험입니다.
-

- 장비 spec
-
가동 온도 범위: 200℃
- 시험 spec
-
시험 조건온도: 125 °C ~ 175 °C
인가 전압: 정격 전압의 80% ~ 100% 수준
시험 시간: 1000 시간 (표준 기준), 필요 시 500 ~ 2000 시간
표준 규격: JESD22-A108(JEDEC), MIL-STD-750 Method 1038 (미국 국방 규격), AQG 324 Release no.: 04.1/2025 Annex SiC QL-05, AQG 324 Release no.: 04.1/2025 QL-05
HTGB
High Temperature Gate BiasHTGB(High Temperature Gate Bias) 신뢰성 시험은 게이트 절연막의 내전압 특성 및 전기적 열화(oxide degradation)를 평가하기 위한 시험.
MOSFET, IGBT 등 게이트 절연 구조를 가진 소자의 신뢰성 검증에 사용됨.
요약:HTGB(High Temperature Gate Bias) 시험은 고온 환경에서 게이트 바이어스를 인가하여
게이트 절연막의 내전압 특성과 산화막 열화(oxide degradation)를 평가하는 신뢰성 시험입니다.
-

- 장비 spec
-
가동 온도 범위: 200℃
- 시험 spec
-
시험 조건온도: 125 °C ~ 175 °C
인가 전압: 정격 전압의 80% ~ 100% 수준
시험 시간: 1000 시간 (표준 기준), 필요 시 500 ~ 2000 시간
표준 규격: JESD22-A108(JEDEC), MIL-STD-750 Method 1038 (미국 국방 규격), AQG 324 Release no.: 04.1/2025 Annex SiC QL-06, AQG 324 Release no.: 04.1/2025 QL-06
H3TRB
High-humidity, high-temperature reverse bias고온·고습 환경에서 역바이어스를 인가하여 반도체 소자의 절연 내습 특성, 패시베이션 안정성, 표면 누설 경로 형성 가능성 등을
평가하기 위한 시험.HTRB에 습도 스트레스가 추가된 형태로, 패키지 밀봉성과 내습 신뢰성을 검증한다.
요약 : H3TRB(High-Humidity, High-Temperature Reverse Bias) 시험은 고온·고습 환경에서 소자에 역바이어스를
인가하여 절연 내습 특성, 패시베이션 안정성, 표면 누설 특성을 평가하는 신뢰성 시험입니다.
-

- 장비 spec
-
항온 항습기 온도 범위: -40~150℃ , 습도 범위 : 30%~98%
- 시험 spec
-
시험 조건온도: 85 °C
상대습도: 85% RH
인가 전압: 정격 전압의 80 % 수준 (또는 소자 사양 기준)
시험 시간: 1000 시간 (일반 기준), 필요 시 500 ~ 2000 시간 조정 가능
표준 규격: AQG 324 Release no.: 04.1/2025 QL-07, JEDEC JESD22-A-101
DRB
Dynamic Reverse BiasDRB(Dynamic Reverse Bias) 시험은 반도체 칩의
기술 신뢰성 인증(Technology Qualification) 단계에서 수행되며, AEC-Q101 외에 추가 시험으로 권장된다.
시험의 주된 목적은 고속 전압 변동(dV/dt) 으로 인한 내부 구조의 빠른 충·방전 스트레스에 따른 열화(Aging) 현상을 평가하는 것이다.
이는 칩 내부 절연 구조, 전하 트랩, 금속 배선 등에서 발생할 수 있는 고주파 전계 스트레스 효과를 조기에 검출하기 위함이다.
요약 : DRB(Dynamic Reverse Bias) 시험은 기술 신뢰성 인증 단계에서 고속 전압 변동(dV/dt)을 반복 인가하여,
내부 절연 구조와 금속 배선 등에 발생하는 고주파 전계 스트레스에 따른 열화(Aging)를 평가하는 시험입니다.
Table 9.15: Test parameters QL-10 Dynamic reverse bias (DRB)
| Parameter | Value |
|---|---|
| Test duration | ≥ 10¹¹ cyclesᶜ |
| Test temperature Tvj * | ≥ 25°C |
| Drain-source over voltage * | 0.8 VDS, Maxᵃ ≤ V_Dₛ ≤ 0.95 VDS, Maxᵃ |
| Drain-source test voltage VDS,DC | < 0>DS, Maxᵃ |
| dVDS/dt turn on * | ≤ -50 V/ns (definition see figure 9.4) (see note) |
| dVDS/dt turn off * | ≥ 50 V/ns ᵃ (definition see figure 9.4) (see note) |
| Switching frequency | 25 kHz ≤ f ≤ 1 000 kHz (see note) |
| Load current IDS * | ≥ 0 A |
| Duty cycle | 40% … 60% |
| “ON” gate voltage VGS,on active mode | VGS,on = VGS,on.recom ᵇ |
| “OFF” gate voltage VGS,off, active or passive mode | VGS,off = VGS,on.recom ᵇ |
DGS
Dynamic Gate StressDGS 시험은 SiC MOSFET의 게이트 절연막 열화와 스위칭 불안정성(GSI)을 평가하기 위한 내구성 시험이다.
JEP195 기준에 따라 칩 수준에서 수행하되, 모듈 병렬 구조에서는 RDS(on)변화 및 전류 분배 문제까지 고려해야 한다.
요약 : Dynamic Gate Stress(DGS) 시험은 게이트에 스위칭 주파수 신호를 반복 인가하여,
SiC MOSFET의 게이트 절연막 열화와 스위칭 불안정성(GSI)을 평가하는 내구성 시험입니다.
Table 9.15: Test parameters QL-10 Dynamic reverse bias (DRB)
| Parameter | Value |
|---|---|
| Test duration | ≥ 10¹¹ cyclesᵃ |
| Test temperature Tvj * | 25°C |
| Drain-source voltage * | VDS = 0 V |
| ABS (dVGS/dt) | ≥ 0.3 V/ns (definition see figure 9.3) |
| Switching frequency | 25 kHz ≤ f ≤ 1 000 kHz |
| Duty cycle | 40% … 60% |
| “ON” gate voltage VGS,on | VGS,max ≤ VGS,on ≤ VGS,max + 0.5 V |
| “OFF” gate voltage VGS,off | VGS,min − 0.5 V ≤ VGS,off ≤ VGS,min |
