서비스
-
불량분석
-
반도체 및 전자부품에 발생하는 기능불량, 성능저하, 파손 등의 원인을 정밀 분석하는 기술
시편준비
적용사례외관/표면 결함분석
적용사례내부/구조 결함분석
적용사례단면 구조 분석
적용사례회로수정
적용사례성분 분석
적용사례전기적특성 분석
적용사례
시편 준비 및 제작(decapsulation)
- 시험목적
-
불량 분석을 위한 내부 구조 및 결함 관찰이 가능한 시편을 확보
- 분석 영역을 노출 시켜 결함의 원인 및 발생 메커니즘 규명
- 분석 목적에 적합한 시편 제작을 통해 정확한 분석 결과 확보
- 시험항목
-
Detach : 제품을 분리 및 반도체 소자를 적출하는 분석
Decapsulation : 반도체 패키지 내부의 Die, Wire, Bonding 영역 등을 노출시키기 위해 패키지 외부 몰딩 Epoxy을 화학적 또는 물리적으로 제거하는 분석
De-Layer: 반도체 Die 내부의 Metal 층 ,Oxide 층 등을 순차적으로 제거하면서 각 층의 구조와 결함을 분석
Cross Section: 반도체 IC, PKG, Module 등의 내부 구조를 수직,수평 방향으로 절단하여 내부 문제를 직접 관찰 하는 분석
외관/표면 결함 분석
- 시험목적
-
제품 외관 및 표면 상태를 확인하여 제조 공정 중 발생 가능한 결함을 조기에 검출 및 Scratch, Crack, Contamination 등 표면 결함의 유무 및 분포 확인
- 결함 발생 위치 및 형상을 분석하여 공정 이상 여부 판단.
- 양산 품질 확보 및 불량 재발 방지를 위한 기초 데이터 확보.
- 시험항목
-
외관검사 : 제품의 전체적인 외형 상태를 육안 또는 광학 현미경으로 관찰
표면 결함 검사 : 표면의 미세 결함을 정밀 관찰
오염분석 : 표면에 존재하는 이물질 확인
산화및 변색 :금속 표면의 색 변화, 산화층 형성 여부 확인
내부/구조 결함 분석
- 시험목적
-
제품 내부 구조를 분석하여 외관상 확인이 불가능한 내부 결함을 검출
- Die, Wire, Solder, Bonding Layer 등 주요 내부 구조확인
- Void, Crack, Delamination 등 내부 결함의 발생 유무 및 분포 확인
- 시험항목
-
X-Ray : X선을 이용하여 시료 내부 구조나 이물, 결함, 조립 불량 등을 실시간으로 투과 관찰할 수 있는 분석
S.A.T: 초음파를 이용해 PKG 내부의 Void, Crack, Delaminatio등 결함을 비파괴로 진단하는 분석
단면구조 분석
- 시험목적
-
단면 가공 진행 후 미세 구조및 내부 결함을 정밀 관찰.
- 미세구모 결함 발생 유무및 형상 확인
- 공정 조건및 특성에 다른 구조적 이상 여부
- 시험항목
-
Ga FIB : Ga Ion 빔을 이용하여 시료의 미세 영역을 정밀 가공하고,단면을 노출해 내부 구조와 결함을 정밀하게 관찰하는 분석
Xe FIB : Xenon 빔을 정밀하게 조사하여 시료의 단면을 가공하거나 미세 결함 부위를 절단·분석
SEM :전자빔을 시료 표면에 조사하여 수 나노미터(nm) 수준의 고해상도 이미지를 제공하는 분석
회로수정
- 시험목적
-
불량 원인 검증을 위해 회로 일부를 선택적으로 수정.
- Open, Short 등 회로 결함 가설에 대한 검증
- 설계오류, 공정결함, Metal 배선 불량 여부 판단
- 시험항목
-
Metal Cutting : 기존 배선을 끊어 회로를 분리
Deposition : 끊어진 회로나 새로운 경로를 금속으로 연결
성분분석
- 시험목적
-
시편의 재료 조성및 성분 분포 확인
- 이물, 공정 잔류물 존재 여부 검출
- 시험항목
-
EDS : SEM과 연계하여 시료 표면의 원소 조성(정성·정량)을 분석
FT-IR:적외선 흡수 스펙트럼을 이용해 유기물 및 화학 결합 구조를 분석
전기적특성 분석
- 시험목적
-
제품의 전기적 동작 특성및 성능 적합성 평가
- 시험항목
-
Curve tracer: 반도체 소자의 I-V 특성을 빠르게 측정하여 기본 전기적 동작 여부를 확인
Paramter Analyzer: 전압·전류를 정밀 제어하여 소자의 정밀 전기적 특성 및 신뢰성 특성을 분석
I-PHEMOS: 소자에 전압·전류 인가 시 발생하는 광 방출(Photon Emission)을 검출하여 전기적 결함 위치를 찾는 분석
THEMOS(PHEMOX-X): 미세 발열 (Thermal Emission)분포를 정밀 측정하여 누설·단락 등 결함을 분석
세라믹 기판
- 시험목적
-
세라믹 기판 제거를 통한 구조 분석
- 세라믹 기판 하부에 발생된 Crack, Delamination, Void 등
- 추가 내부 구조 분석을 위한 정확한 시편확보
시편준비 및 제작 적용사례
Detach (시료 분리 및 적출)
-
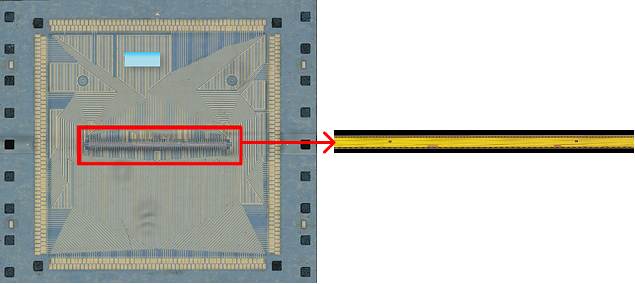
COF - Driver IC Detach
-

SMT PKG - Detach
Decapsulation
-
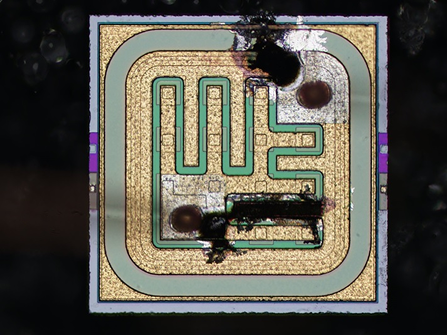
Metal Burnt
-

Wire Open
-

Metal Burnt
Delayer
-
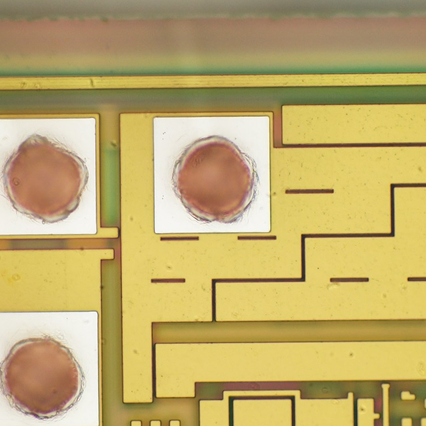
M5
-
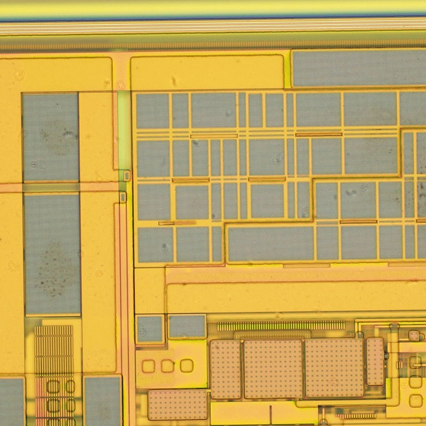
M4
-
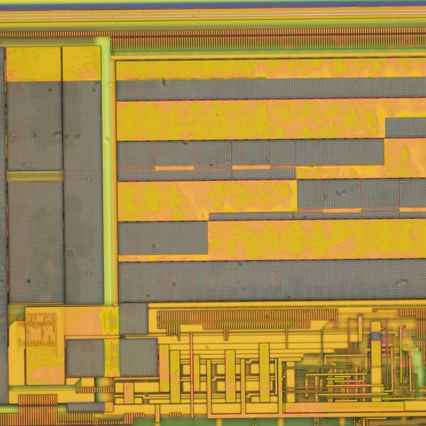
M3
-
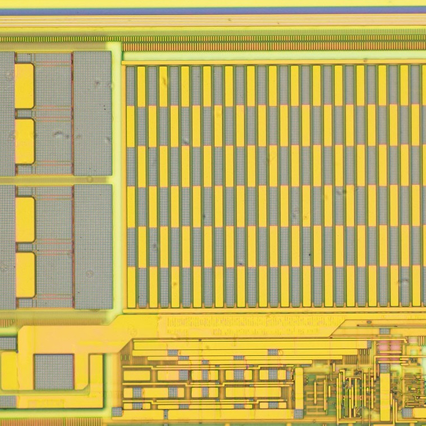
M2
-

M1
-
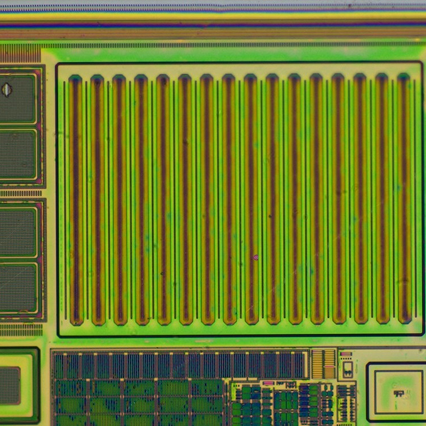
Active
Cross Section
-

Solder Ball Void
-

IC Chip Crack
-
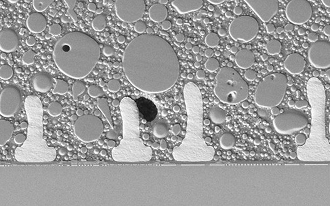
EMC Void
-
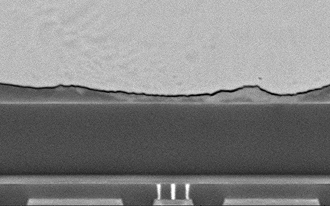
Ball-Pad Delamination
외관/표면 결함 분석 적용사례
-
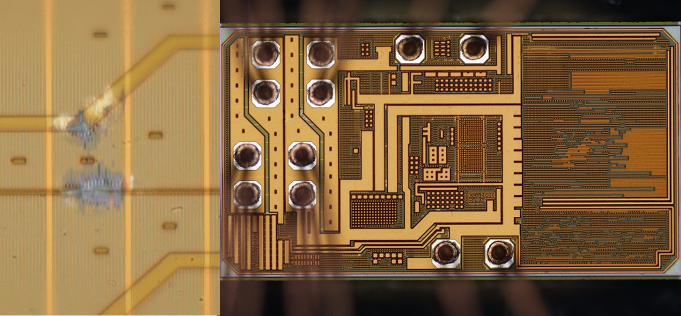
Metal Melting
-
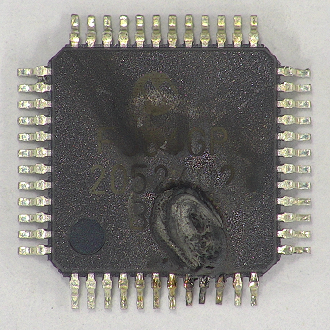
EMC Carbonized
-
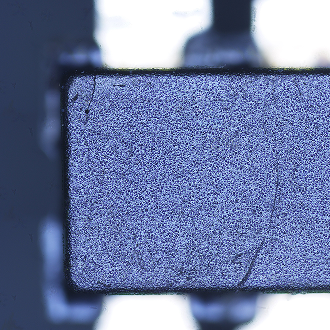
EMC Crack
내부/구조 결함 분석 적용사례
X-Ray
-

내부 Crack
-

PKG Structure
-

PKG Structure
S.A.T(초음파검사기)
-
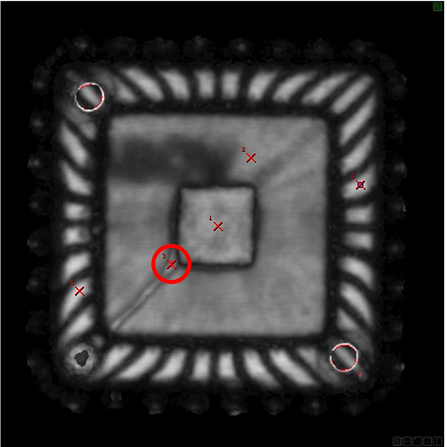
C-Scan
-

A-Scan
-

T-Scan
단면구조 분석 적용사례
SEM Inspection
-

Sub Damage
-

Metal Burnt
-

Contact Spike
-

Whisker
Ga-FIB
-
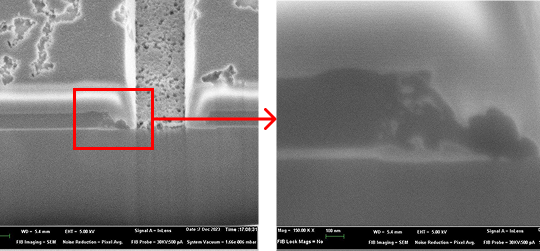
Poly Melting
-
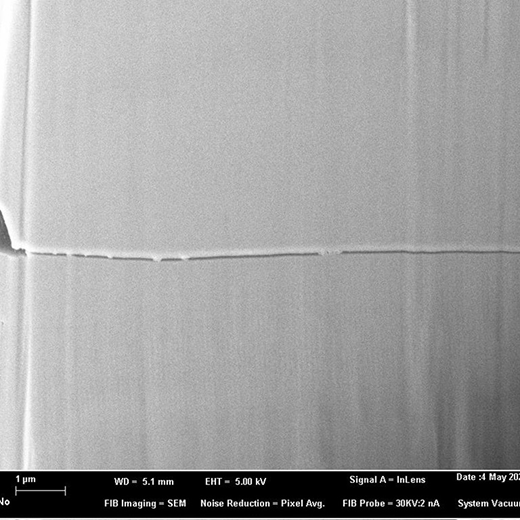
IC Crack
-

Structure
-
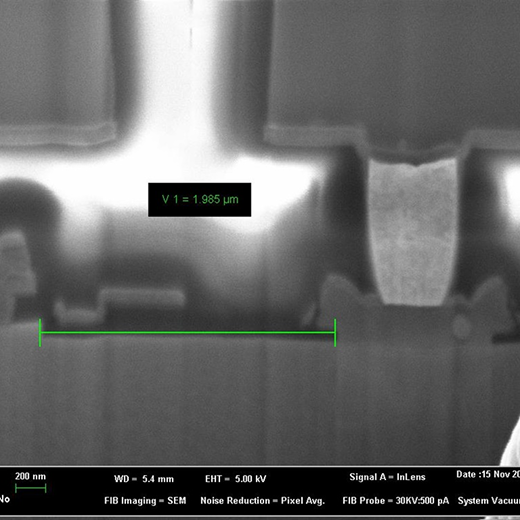
measurement
Xe FIB
-

W x H : 300 um x 80um
-

W x H : 100 um x 80um
-

W x H : 150 um x 150um
회로수정 적용사례
-

PAD 제작
-
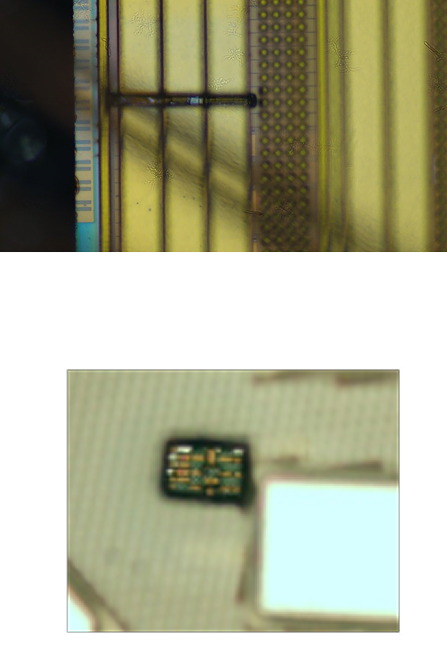
Metal Line Cutting
-
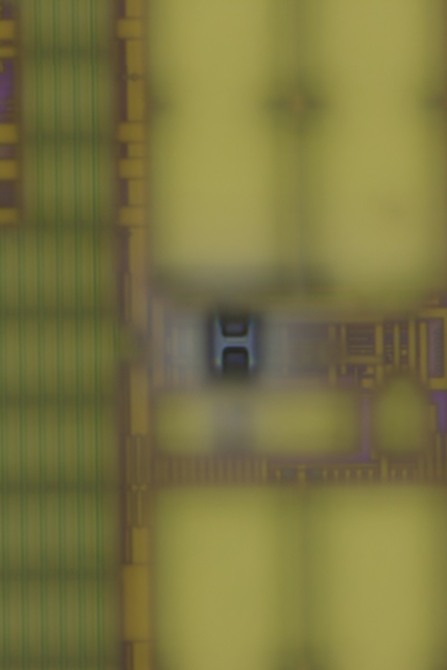
Under Metal Line Cutting
성분분석 적용사례
FI-IR
-

Poly Carbonate
-

Polymer 제조사 및 품명
EDS
-

Mapping
-

Point
전기적특성 분석 적용사례
Curve Trace
-

Open
-

Short
-

Leakage
I-PHEMOS
-

InGaAs
-
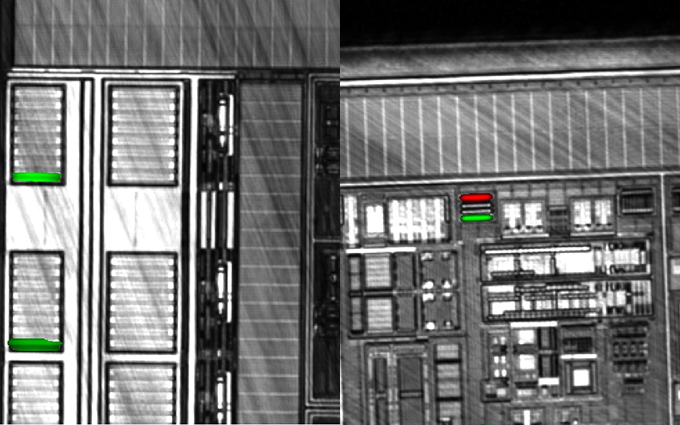
Laser- OBIRCH 측정
THEMOS(PHEMOS-X)
-
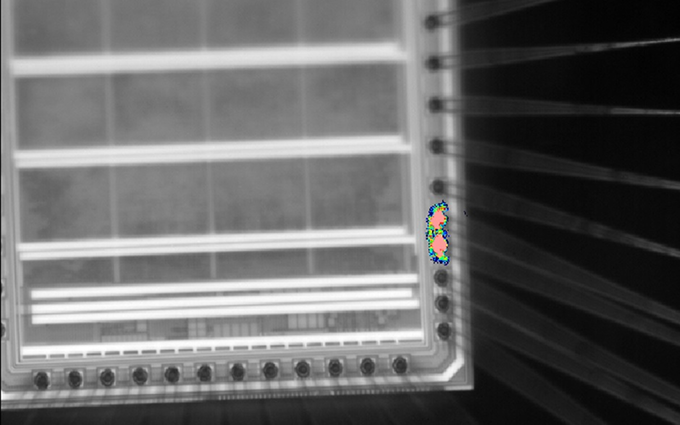
Top Side Hot Spot 검출
-

Bottom Side Hot Spot 검출
세라믹 기판
-

단면 분석_Ceramic Crack
-

IC 노출
-
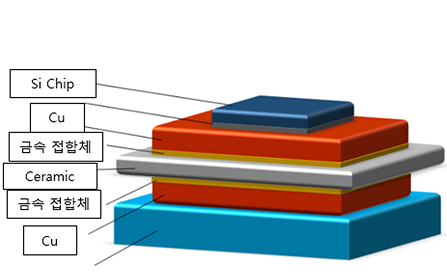
Ceramic PKG 구조
주요 설비 현황
-
 <!-- Olympus BX53M -->
<!-- Olympus BX53M -->자동 촬영 현미경 (Auto Microscope)
- 접안렌즈 10x
- BF/DF/PO용 반사광 LED 조명 유닛
- 대물렌즈 5x ,10x ,20x, 50x ,100x
- 전동 스테이지 시스템 적용
-

디지털 현미경 (Digital Microscope)
- 카메라 사양 FHD 1080p, 1920x1080@25/30/50/60Hz
- 렌즈 x4, x10
- 촬영 영역 최소: 100mm, Max : 310mm
-

X-Ray
- 튜브
- 160 kV / 200 µA (옵션 500 µA)
- 해상도
- 0.8 µm - 0.9 µm
- 검사 영역
- 460 × 510 mm
- 이동 축
- X, Y, Z, Tilt (70°), R, Y-aft, Cone beam R
-

S.A.T
- 스캔 영역
- 약 380 × 360 mm
- 정밀도
- ±0.5 µm의 반복 정밀도로 스캔 가능
- 트랜스듀서 지원 주파수 범위
- 2.25 MHz ~ 100 MHz 다양한 주파수 지원
- 스캔 기능
- A/T/C/TAMI스캔
-

SEM
- 해상도
- 1.2nm @ 15 kV, 1nm @ 1 kV, 500nA
- 배율
- 12 - 100,000x
- 가속전압
- 0.1 - 30 kV
- 프로브 전류
- 4 pA - 10 nA (20 nA optional)
- 이미지 프로세스 해상도
- 3072 x 2304 pixel
- EDS(성분분석)
- 지원
-
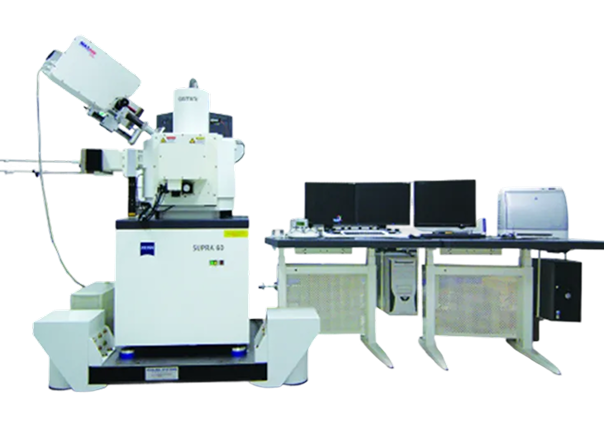
Fe - SEM
- 해상도
- 1.0 nm @ 15 kV ,1.7 nm @ 1 kV
- 배율
- 12× to 1,000,000×
- 가속전압
- 0.1 kV to 30 kV
- 프로브전류
- 1 pA to 20 nA
- 이미지 프로세스 해상도
- Up to 3072 × 2304 pixel
-

Xe - FIB
- 분해능
- <0>
- 배율
- 600x - 500kx
- 전자빔사양
- 200V to 30kV
- 이온소스
- Xe 가스
- EDS(성분분석)
- 지원
-
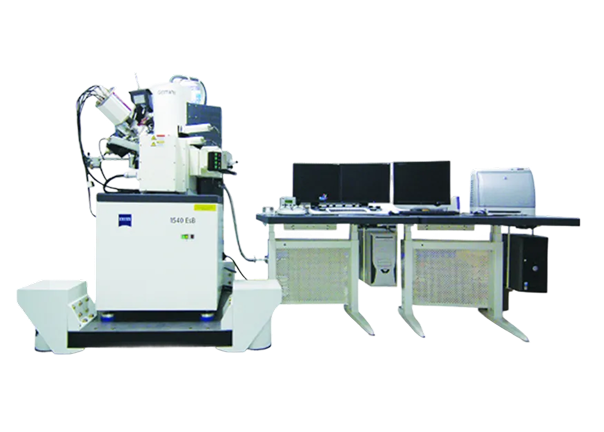
Ga FIB
- 분해능
- 7 nm @ 30 kV guaranteed, 5 nm achievable
- 배율
- 600x - 500kx
- 프로브전류
- 1 pA - 50 nA
- 이온소스
- Ga 액체금속
- EDX (성분분석)
- 지원
-

FT-IR
- 분광 범위
- ≥ 7,800 to 450 cm⁻¹
- 분광 해상도
- ≤ 0.4 cm⁻¹
- 스캔속도
- ≥ 5 scans/sec
- 배율
- ≥ 150x
- 해상도
- ≤ 6 µm
- 시료 분석가능 크기
- ≥ 75 x 50 x 40 mm
-

EDS
- 면적
Max 100 mm²
- 분해능
Mn Kα : 129 eV (ISO 15632)
- 최대 계수율
Max 10,000 cps (counts per second)
-

Curve Tracer
- 전류 분해능
- 10 fA (HPSMU)
- 전압 분해능
- 0.5 µV
- 측정 범위
- 최대 1,500A/ 10kV
-

Manual Grinder
- 치수
- 2인치, 8인치
- 회전 속도 제어
- 10 ~ 500 RPM(10 RPM 단위 조절)
-

THEMOS(PHEMOS-X)
- 검출기
- 열화상 카메라
- 파장대역
- 1700nm ~ 5300nm
- hermal Lock-in 기능
- 지원
- 프로브 스테이지 척 크기
- 150mm , 1.5kV 전압 지원 기능
-

I-PHEMOS MPX
- 검출기
- InGaAs 카메라
- 파장대역
- 약 0.9 ~ 2.6 µm
- 광원 탑재
- 지원 (OBIRCH)
- 프로브 스테이지 척 크기
- 12인치
-

Wet Station
- 주요 사항
-
- 내 산성 흄 후드
- 내 산성 스크러버
- 내 산성 배기형 시약장
시험 절차
분석 서비스 상담
분석 의뢰 접수 (E-mail)
견적 산출 및 일정
분석 시험
결과 보고서 발행
-
문의 및 연락처
-
1533-2132
raon@raonsolution.com
